안녕하세요~~ 투자하는 아재입니다.
오늘은 반도체의 미래인 EUV에 대한 전체적인 이해와 관련 기업 에스엔에스텍 & 지오엘리먼트를 소개하도록 하겠습니다.
1.31일 삼성전자의 22년 4분기 최종 실적발표가 있었습니다. 결론적으로 어닝 쇼크로 전년 동기 대비 영업이익이 -69%가 났지만 어느 정도 예상된 부분으로 적자인 SK하이닉스와 마이크론에 비하면 양호하다 생각됩니다. 더욱이 파운드리에선 역대 최대 매출과 이익을 가져갔다는 부분에서 고무적이라 하겠습니다.
삼성전자에 대해선 간단하게 여기까지 하고, 본론으로 들어가겠습니다.
최근 삼성은 CMOS, DDI 등의 반도체를 외주(대만의 UMC 등)에 맡기기로 결정하면서 점유율 부분에서 더욱 큰 성장세가 기대됩니다. 삼성전자 주주 분들 인내하셔야 합니다.
지금은 일부의 업체들만 EUV를 사용하지만 대부분의 전문가들은 수년 내에 EUV가 보편화될 것으로 판단하고 있습니다. 그렇기에 반도체에 투자하는 투자자들에게 EUV 관련 기업들에 투자하는 것은 매우 매력적인 일이라고 생각됩니다.
EUV에 관해서는 여러 번 말씀드렸지만, 13.5nm의 극자외선(Extreme Ultra-Violet)의 파장의 광원을 사용하는 노광공정 및 제조공정을 EUV라 합니다.
EUV 광원의 특징으로는 공기 중 흡수 반사 산란 등으로 일반적인 DUV광원에 배해 손실률이 매우 높습니다. 그래서 ASML(네덜란드) 사의 EUV 노광 장비가 필수입니다. 더욱이 손실률이 많고 굉장히 까다롭기 때문에 고출력을 통해 일부의 광원만을 사용하게 됩니다.
그렇기에 EUV의 핵심은 아래와 같이 크게 두 가지로 볼 수 있습니다.
1. 높은 고출력을 통해 얼마나 많은 EUV를 만들어 낼 수 있는가?
2. EUV를 얼마나 낮은 손실률로 활용할 수 있느냐?

ASML의 EUV 노광장비(SCANNER) 내부의 모습으로 우측의 일반적인 노광공정과는 다르게 빛을 여러 번 반사해 주는 것을 알 수 있습니다. 이는 앞에서 말한 바와 같이 빛의 손실률을 줄이기 위한 방법입니다.
이 EUV를 발생시키기 위해서는 Laser Induced Plasma라는 기술이 사용됩니다. 이 기술은 광원을 모아주는 CO2 Laser를 Sn(주석)이나 Xe(제논) 방울에 쏴 주면 Plasma가 발생되고, 이때 발생되는 극자외선을 모아 EUV 광원으로 사용하게 됩니다.

위의 사진은 일반적인 공정인 DUV의 노광공정에 관한 process에 관하여 도식화한 것입니다.
광원(Light source)이 렌즈(Reduction optics)를 통과하고 가시 Mask(패턴이 그려져 있는 포토마스크)를 통과하여 1/4 정도로 축소된 빛이 웨이퍼(Wafer)에 패턴을 새겨 넣는 과정으로 진행됩니다. 위의 그림처럼 마스크와 웨이퍼 사이에 다시 렌즈(Reduction optics)를 사용하기도 합니다.
혹시라도 공정에 대한 이해가 부족하시다면, 저의 과거의 글 중 "반도체 8대공정"에 관한 글을 공부하시고 오시길 권해드립니다.
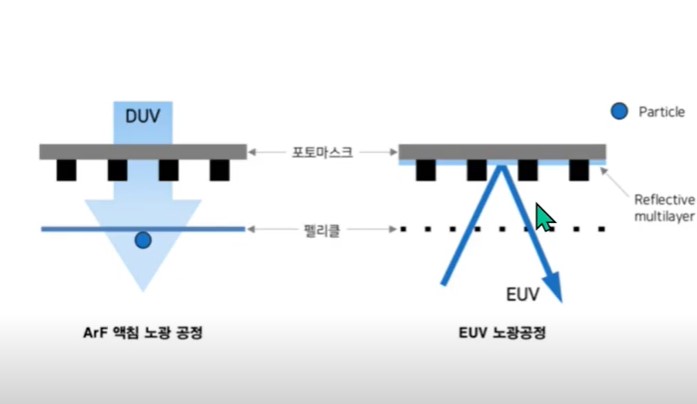
여기서 펠리클은 포토 마스크를 보호해주는 보호막으로 수억 원(2억)에 달하는 EUV용 마스크를 수천만 원(2~3천만)의 펠리클을 사용하여 수명을 늘려주어 수익성을 높여주기 위해서 사용합니다.
그렇기에 펠리클의 핵심은 투과율과 내구성입니다.
위에서 보듯이 DUV(ArF공정) 대비, EUV는 두 번 펠리클을 통과하여야 합니다. 또한, 고출력의 손실률이 높은 EUV 광원을 사용하기에 EUV용 펠리클은 DUV용 펠리클 대비 더 투과성이 아주 높게(두께가 얇게), 내구성 또한 아주 좋아야 하기에 굉장히 어려운 기술입니다. 투과성이 낮으면 공기 중에서 손실된 일부의 EUV 광원마저 펠리클에 흡수되어 패턴이 그려지지 않을 것입니다. 또한 내구성의 낮으면 마스크를 보호해 주는 펠리클의 역할을 수행하지 못할 것입니다.
여기서 우리가 알아야 할 것은 EUV용 블랭크 마스크는 마스크에 패턴이 그려져있지 않은 순수한 마스크로 단어 그대로 블랭크, 비어있는 마스크를 의미합니다. 이 블랭크 마스크를 반도체 설계에 따라 패턴을 그려 넣는 작업을 통해 노광에 사용되는 포토마스크로 탄생됩니다. 이과정에서 우리는 두 기업에 주목해 봐야 할 것입니다.
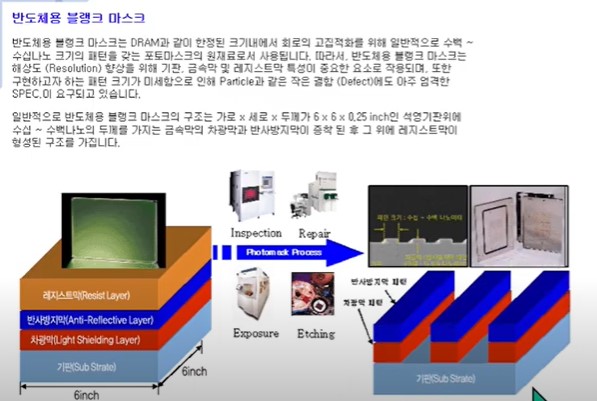
에스앤에스텍
최근 EUV용 블랭크 마스크를 개발 중에 있으며, EUV용 블랭크 마스크를 생산하기 위해선, 미국 비코 인스트로먼트(VEECO)의 이온빔 증착(IBM) 장비가 반드시 필요하고 이장비가 탈탄늄계에 적합하게 만들어졌습니다.
에스앤에스텍은 핵심 기술인 흡수체와 위상반전에 관한 특허를 다수 보유 중에 있습니다.
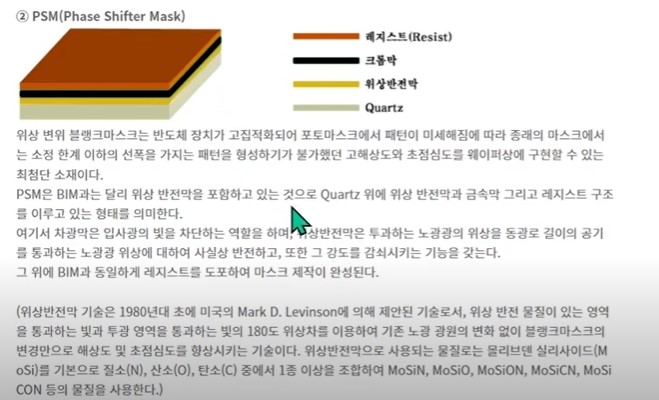
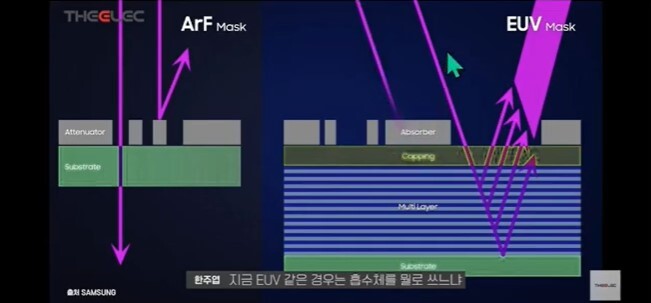

하지만, 탈탄늄계 소재의 단점은 두께를 얇게 만들지 못하여 그림자 현상이 발생된다는 한계점이 있습니다.


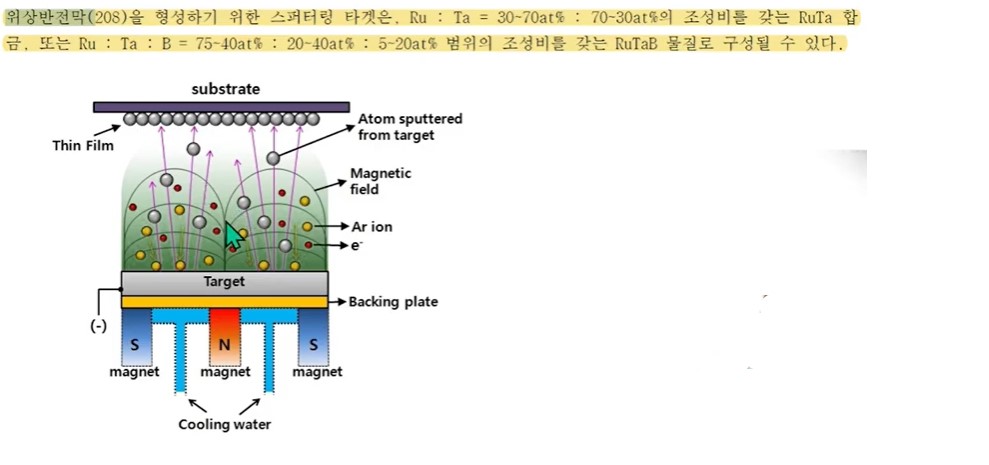
이렇게 스퍼터링 타깃을 이용하는 것은 미국의 비코 인스트루먼트의 IBM(이온빔 증착 장비)를 이용하기 위함임을 알아야 합니다(장비 도입 추진 중입니다)
여기서 그동안 일본 기업을 중심으로 미국의 소수의 기업들만이 만들고 있는 스퍼터링 타깃에 대한 국산화의 성공에 근접한 기업이 "지오 엘리먼트"입니다.


위는 탈탄늄계 소재를 스퍼터링 타깃으로 이용하여 PVD(물리적 증착 방식)으로 EUV용 블랭크 마스크를 국산화하겠다는 국책 사업의 특허에 관한 내용입니다.
지오 엘리먼트(정리)
EUV 관련 ALD(원자층 기상 증착) 소재 관련 기업으로 알려졌으나 최근 에스앤에스텍의 EUV용 블랭크 마스크에 필요한 흡수체(탈탄늄계)와 위상 반전(접하는 EUV 광원을 상쇄시키는) 기술을 위한(정교한 EUV용 블랭크---> 포토마스크) PVD(물리적 기상 증착방식) 스퍼터링 타깃용 소재 국산화를 위해 노력 중입니다. 흡수체와 위상반전 막에는 탄탄늄계 소재가 쓰이는데 현재는 미국과 일본 소재 기업에서 전량 수입 중으로 막대한 료열티를 지급하고 있습니다. 현재 국산화를 위해 지오 엘리먼트에서 연구 개발 중입니다.
EUV 공정은 반도체의 미래의 미세공정을 책임질 핵심 기술이라 생각합니다.
우리는 투자자로서 관련 EUV에 관해 공부하고 관심 가져야 할 것으로 생각됩니다.
'반도체, 삼성전자' 카테고리의 다른 글
| 반도체의 미래 EUV PR 국산화 성공 동진쎄미켐 이걸로 끝~! (0) | 2023.02.09 |
|---|---|
| 반도체의 미래 [EUV용 펠리클] "에프에스티" (3) | 2023.02.08 |
| 글로벌 반도체의 흐름 (4) | 2023.01.20 |
| TSMC와 삼성전자의 3나노에 대해서 (2) | 2023.01.19 |
| "삼성전자"매도하지 마세요 (0) | 2023.01.01 |




댓글